1,��������Ҫ�㶮һ������:ΪʲôҪ���а弶�����?
�ܽ��˴�������漸��ԭ��:
a,�豸�����С,��������,�����ܶȴ������.
b ���¶Բ�Ʒ�IJ���Ӱ��: Ԫ������(ը��);��Ե�����½�;�����ϻ�����: ���쿪��,������������ȵ�.
c, ���¶�Ԫ������Ӱ��:���������½�;������ֵ�仯;����������Ե���������½�;����ܹ���������.
d, ɢ����������Լ��ƷС�ͻ�����㻯�Ĺؼ�����.
2,����,����Ҫ�˽����ǵ��о�����,��Ҫ������������������,���������ص��ǹ��ڵڶ����弶������ơ�
a, Ԫ���������:
�о�Ԫ�����ڲ��ṹ�����װ��ʽ�Դ��ȵ�Ӱ��,���㼰����Ԫ�������¶ȷֲ����Բ��ϡ��ṹ���������,��������,���Ӵ���;��,��ߴ���Ч��,�ﵽ�����¶ȵ��յġ���Ԫ����������������ɡ�
b, ��·�弶�������:
��Ҫ�о���·��Ľṹ��Ԫ�������ֶ�Ԫ���¶ȵ�Ӱ���Լ������豸����·����¶ȷֲ�,�������Ԫ���Ľ���¶�,���пɿ�����ơ��Ե�·��ṹ����Ԫ�������к�������,�ڵ�·�弰�����������ڲ�ȡ�ȿ��ƴ�ʩ,�ﵽ�����¶�Ŀ�ġ�
c, �������������:
�о������豸�����������¶ȶ����Ӱ��,�����¶��ǵ�·�弶���ȷ�������Ҫ�߽���������ȡ��ʩ���ƻ����¶�,ʹ�����豸�����˵��¶Ȼ����¹�����
3,����������Ҫ��,����Ҫ֪������Щ����ȥ���ֲ���������Ƹ��ơ�
�����Ĵ����е���,�������ȼ��ȷ������ַ�ʽ,���Ի��������и���ɢ�ȵķ������벻�������ַ�ʽ��
���濪ʼ���ǵĺ�������,PCB�������θ���ɢ��?
1,PCB��������ϵ�ɢ�����:
a, �����PCB�岼��ǰ,��Ҫ���PCB������Ƶķ����������,��������ɢ���ߴ�������,����ϲ�Ҫ�и�������ס�����
��Ϊ�������������������õ�һϵ����������Ҫ��ɢ����ʱ,����������������������в���,���Խ�����������������Ӱ�졣������������,Ҳ��Ҫ���⽫�ߴ��Ԫ����(�ṹ����)���ڸ߷���Ԫ�������Ϸ���
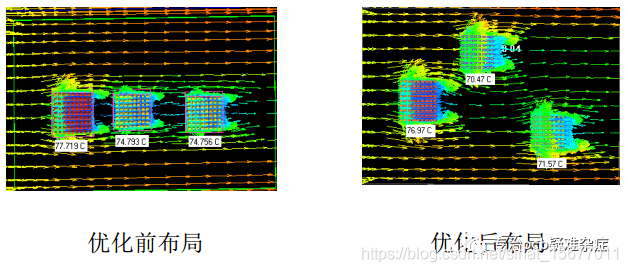
b, ͬһ��ӡ�ư��ϵ�����Ӧ�����ܰ��䷢������С��ɢ�ȳ̶ȷ�������,������С�������Բ������(��С�źž���ܡ�С��ģ���ɵ�·�������ݵ�)������ȴ������������(��ڴ�),��������������Ժõ�����(�繦�ʾ���ܡ����ģ���ɵ�·��)������ȴ������������
c, ���¶ȱȽ����е�����Ҫע�Ⲽ�ֵ�λ��,����һЩ�¶ȹ��ϵ͵ľ��������һЩ������������,��ð����ڽ���ڴ������¶���͵�����(���豸�ĵײ�),��Ҫ�������ڷ������������Ϸ���
d, ��Ԫ�����ķ����ܶȳ���0.6W/cm3,����Ԫ���������ż�Ԫ���������Ѳ����Գ��ɢ��,Ӧ���Dz�������ɢ��������ȵȴ�ʩ��
e, ��ģ���ڲ����ܴ������PCB��,�ڲ���Ԫ����ʱ,Ԫ������ṹ��֮��Ҫ����һ���ľ���,�����ڿ�������,��ǿ�������ȡ�
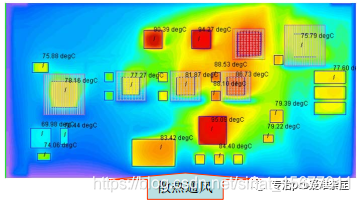
f, ��������ɢ��Ƭ���,���е��緽��Ҫ���ɢ��ƬҪ�ͷ���һ��,ɢ��Ƭ�·�����������������,���������ʹ��к��ڲ���Ҫ���������ʹ�ö�λ�̶���ɢ��Ƭ�����㹻������û���κθ�������
g,��������ɢ���������ǿ����,�Դ��������ɿ��Ǽ�ɢ����,�������÷��ȵ�,�����ˮ����Ƶȷ�ʽ��ǿɢ�ȡ�
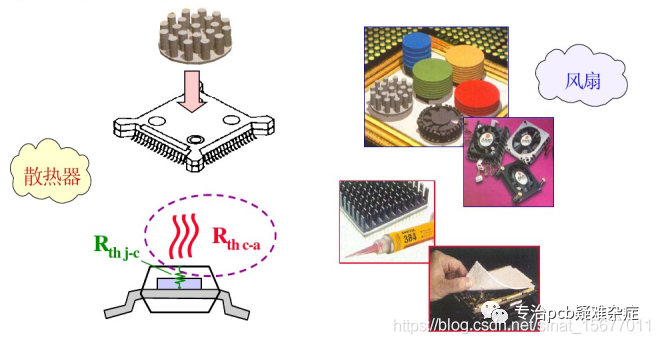
2,PCB�����ϵ�ɢ�����
a, ɢ�ȹ������
ɢ�Ⱥ����¼ӹ���ɢ�ȵ�Ч�������Ե�,����ɢ�ȹ������Ҳ���ھ����ȴ�������ϡ�
**ɢ�ȹ�����Ҫ�����Dz����֮����������Լ����ӷ����ϵĵ���������**�����������˵,������ɢ�����õ�ֻ������PAD�ײ��Ĺ��������ӵعܽ��Աߵļ�������,�ⲿ�ֹ�����ƾͷdz���Ҫ��
һ�������,ɢ�����ŵĹ�����Ʒ���Ϊ:��10~12mil,�����ļ��30~40mil,Ҳ���Ը����������Ⱥ�ˮƽ���¶ȿ���Ҫ��Թ������������Ż�
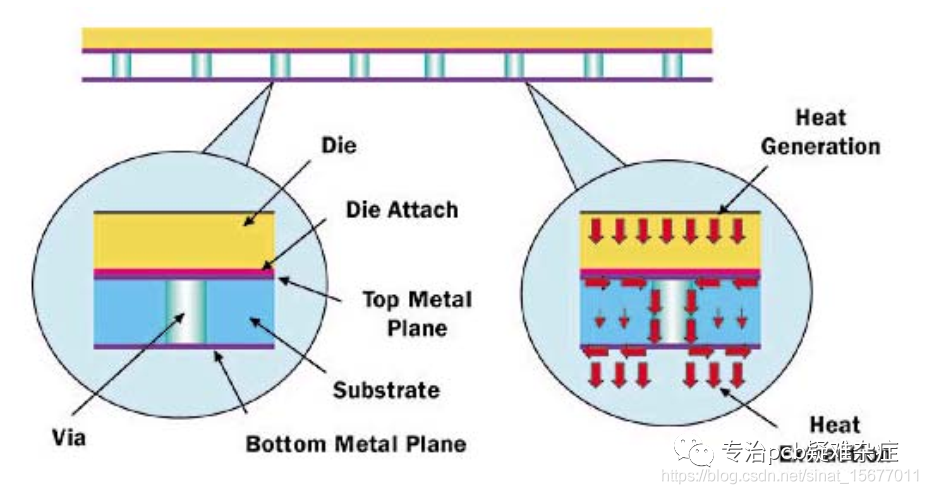
����������ɢ�ȿ�δ����ɢ�ȿĶԱ�ͼ

��ɢ�Ⱥ��̱��������߿�����ͭ����Ч����,���������ɢ����Ӱ��?�����ӵ���ϵ���ķ�����,�Ƿ����Ե���ϵ��Ӱ���С�����������ײ���©��,�������п�Ѩ������©������Ӱ��ƽ������
b, ����ɢ��ͭ�����
������Ƶ�����Ǿ������������ͭ������,��ʵ����Ϊ��ɢ�ȡ�����˵������ɢ��ͭ��,������������ͭ���,����ͭ��ͭ��,����ͭ�������ȵ�,��������ɢ��ͭ���ķ�ʽ��
ͭƤ�������ǰѾֲ������·���������չ������ķ�Χ��,�������ͭƤ�ĺ�ȿ�����ǿ����Ч��������ͭƤֻ��������ͭƤ������������������,�����Ҫע��ͭƤ�ķָ
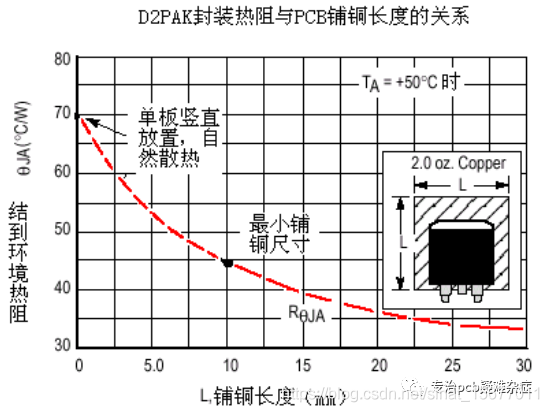
c, ICɢ�Ⱥ��̼ӹ����濪����ͭ Ҳ����������ɢ�ȵ�һ�ַ�ʽ��
d, ʹ����������,ͨ���ֲ����������ѹ�Ĺ���,���ﵽ�ֲ�ɢ�ȵ�Ŀ�ġ�
3,���Ƿ���ӹ��Ե���ƽ�����
a, ��Ƭʱ����ɢ���ٶȿ���������Ӧ������,����������Ӧ������,���������Ȳ���;����0402 0201����С�ķ������� ��������֮���Ӧ�þ����Գ���ơ�
b, ���������������ž�����Ҫֱ�ӷ����ڴ�ͭ����,����ɢ�ȹ��쵼�º��Ӳ���
c, ͨ�ײ��������Ƴ��Ⱥ���,������,����Ͷ��ƽ��ȫ���ӡ��������µĽ�� ����ɢ�ȹ��� �������Ų�����������
ԭ������:https://blog.csdn.net/qq_42053636/article/details/118851224
cs